世界芯片切割市場的較大份額,特別是在非集成電路晶圓劃片領域。金剛石鋸片(砂輪)劃片方法是目前常見的晶圓劃片方法。,傳統(tǒng)刀片進行劃片極易導致晶圓破碎,且劃片速度較慢,切割刀片需要頻繁的更換,后期運行成本較高。
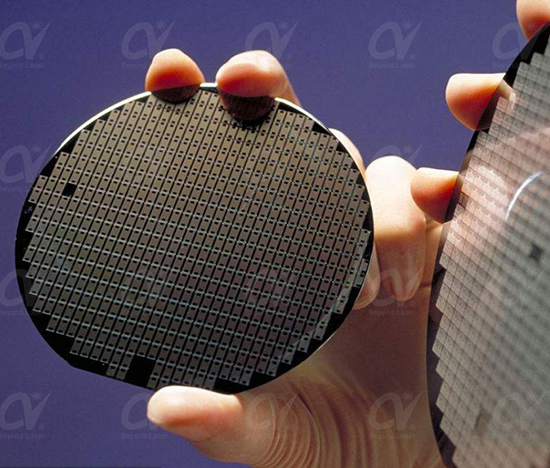
新型劃片-激光,激光屬于無接觸式加工,不對晶圓產(chǎn)生機械應力的作用,對晶圓損傷較小。 由于激光在聚焦上的優(yōu)點, 聚焦點可小到亞微米數(shù)量級, 從而對晶圓的微處理更具優(yōu)越性, 可以進行小部件的加工; 即使在不高的脈沖能量水平下, 也能得到較高的能量密度, 有效地進行材料加工。

加工優(yōu)勢: